互连,缓解封装体内部的机械应力,提供从封装体内功率器件到外界环境的热传递路径,使芯片间的引线从封装体牢固地引出而非直接装配在基片上等功能。封装技术的优劣直接关系到芯片自身性能的发挥以及与芯片连接的
高密度封装应半导体技术的发展,实现电子器件由二维(2D)平面堆集到沿Z方向的高密度集成,以缓解、延续或超越摩尔定律的发展。
1965年,美国仙童半导体公司的Gordon Moore博士提出了著名的Moore定律:当价格不变时,集成电路上可容纳的元器件数目,每隔18-24个月就会增加一倍。
这一定律准确预测了过去五十年半导体行业的发展。随着电子信息产业的不断升级,半导体集成电路正在向超大规模、超高速、高密度、大功率方向发展,当晶体管特征尺寸达到纳米级后,进一步减小晶体管尺寸无疑是困难且昂贵的,这也意味着摩尔定律接近尾声。
基于这种情况,业界提出了超越摩尔定律(More-Than-Moore,MTM),试图从的一些途径来延续摩尔定律的发展趋势,并且从摩尔定律的“更多更快”,发展到MTM的“更好更全面”。如通过优化晶体管的设计,寻找硅的替代品和发展先进封装技术等,使一块集成电路芯片能够同时具有多种功能,这不仅可以降低芯片的生产成本还能提高电路的等效集成度。其中先进封装技术的应用无疑是后摩尔时代集成电路发展最有效的解决方法之一,特别是电子封装维度从二维(2D)向三维(3D)发展,通过三维片上集成、硅通孔(TSV)芯片互连和三维封装堆叠的形式,在晶体管特征尺寸不变的情况下,可以成倍的增加集成电路密度,从而更好的延续摩尔定律。
但FC封装中硅基芯片与高分子基封装基板之间热膨胀系数(Coefficient of Thermal Expansion, CTE)不匹配产生的热应力易造成焊点在热载荷作用下过早产生疲劳断裂乃至失效。1987年日本日立(Hitachi)公司Nakano首次提出在环氧树脂中加入SiO2并将其填充在芯片与基板之间来提高焊点的疲劳寿命,这种填充树脂后来逐渐发展成为底部填充胶(Underfill),也称为底部填充剂或底填胶等。
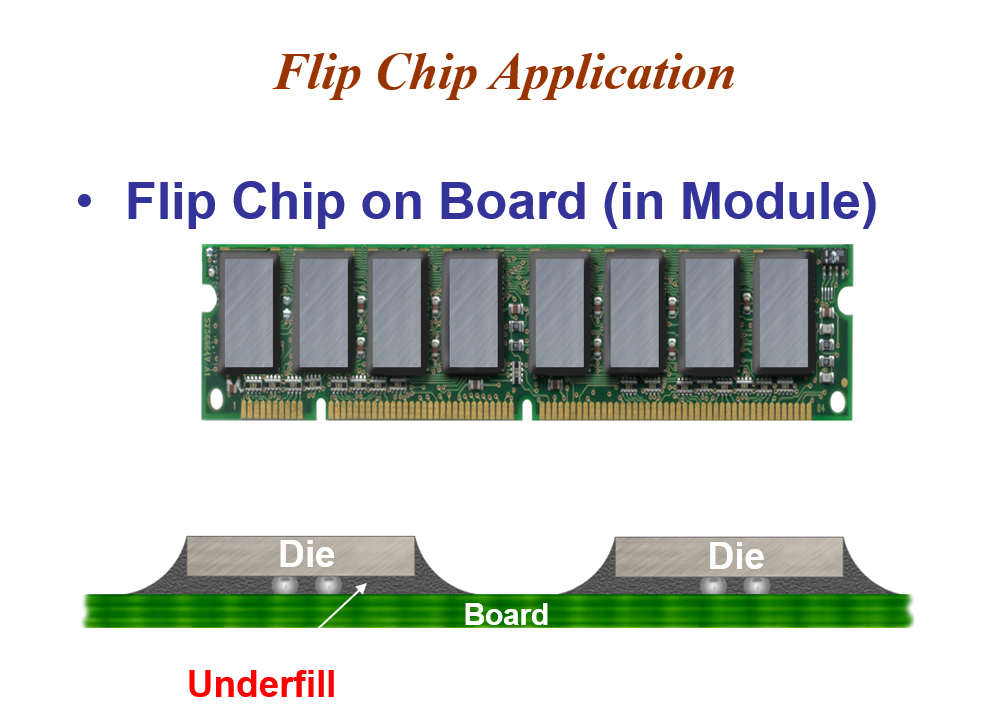
的原因 /
详解 /
的基本特性 /
胶点胶工艺基本操作流程 /
材料 /
,在选择智能手机的时候,用户不仅关心手机外观颜值,更关注性能。5G手机时代,为了满足手机性能的可靠性,维持电池充放电过程中的安全稳定,需要
胶 /
工艺用胶解决方案由汉思新材料提供随着手机、电脑等便携式电子产品的发展趋向薄型化、小型化、高性能化,IC
工艺用胶解决方案 /
胶应用由汉思新材料提供客户产品为:车载多媒体显示屏主板用胶部位:车载多媒体显示屏主板有多个BGA器件需要点胶BGA
胶应用 /
胶应用方案由汉思新材料提供客户生产产品:出口日本的扫描仪产品用胶部位:扫描仪的一块主板上有好几种规格BGA
胶应用方案 /
胶应用 /
胶 /
胶 /
胶 /
【昉·星光 2 高性能RISC-V单板计算机体验】以容器的方式安装 HomeAssistant
上一篇:生物质锅炉用耐火浇注料 高铝浇注料 铝酸盐 下一篇:仿生医美接棒再生医美是噱头还是风口?